Rasterelektronenmikroskopie (SEM)
Bei der Rasterelektronenmikroskopie (SEM von engl. Scanning electron microscopy) wird die Probe mithilfe eines Elektronenstrahls abgebildet der die Probe über ein Raster scannt. Wenn die Elektronen auf die Probenoberfläche treffen interagieren die Elektronen mit den Atomen in der Probe und eine Menge an Informationen wird erhalten. Zum Beispiel durch Detektierung der rückgestreuten Elektronen von der Kollision erhällt man Informationen über Atomnummer und Topographie. Durch Analyse der Röntgenstrahlung der durch die Kollision erregten Atome erhält man informationen über die Zusammensetzung der Probe.
Durch die große Tiefenschärfe dieser Technik können Oberflächen mit großen Unterschieden in der Topographie abgebildet werden, z.B. Bruchflächen. Die Analyse kann bei mehrerer hundertausendfacher Vergrößerung mit einer Auflösung auf Nanometerniveau durchgeführt werden.

Ergebnis (Beispiel)

Sekundärelektroennbild (SE2) einer Schraube mit Verschleißschäden.
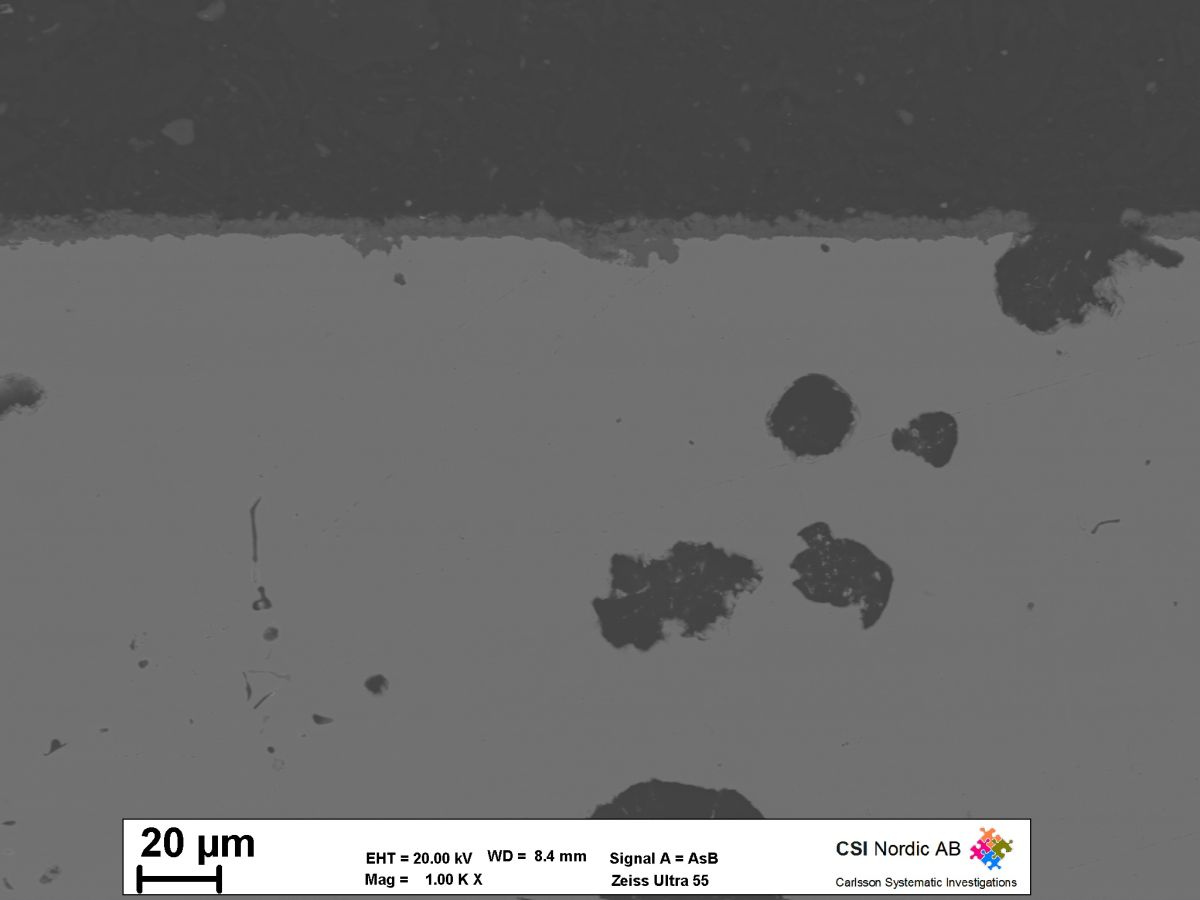
Rückstreuelektronenbild eines Schnitts durch beschichteten Stahl.

